Search Thermo Fisher Scientific
Plasma focused ion beam instrument
Helios 5 Plasma FIB DualBeam FiB SEM Microscope(Helios 5 等离子双束聚焦离子束扫描电子显微镜)
Thermo Scientific Helios 5 Plasma FIB (PFIB) DualBeam(聚焦离子束扫描电子显微镜或 FIB-SEM)是具有无与伦比的功能,专用于材料科学和半导体应用的显微镜。材料科学研究人员可以通过 Helios 5 PFIB DualBeam 实现大体积 3D 表征、无镓样品制备和精确的微加工。半导体设备、先进包装技术和显示设备的制造商通过 Helios 5 PFIB DualBeam 可实现无损伤、大面积反处理、快速样品制备和高保真故障分析。
无镓 STEM 和 TEM 样品制备
由于新 PFIB 色谱柱可实现 500 V Xe+ 最终抛光和所有操作条件下的优异性能,因此可以实现高质量、无镓 TEM 和 APT 样品制备。
先进的自动化
使用选配的 AutoTEM 5 软件最快、最简单地实现自动化的多点原位和非原位 TEM 样品制备以及横截面成像。
新一代 2.5 μA Xenon 等离子 FIB 色谱柱
使用新一代 2.5 μA Xenon 等离子 FIB 色谱柱 (PFIB) 实现高通量和高质量的统计学相关 3D 表征、横截面成像和微加工。
多模式亚表面和 3D 信息
使用选配的 Auto Slice & View 4 (AS&V4) 软件,访问高质量、多模式亚表面和 3D 信息并精确定位感兴趣区。
低能量下具有亚纳米性能
凭借具有高电流 UC+ 单色器技术的一流 Elstar 电子色谱柱,可以在低能量下实现亚纳米性能,从而显示最细致的细节信息。
完整的样品信息
可通过多达六个集成在色谱柱内和透镜下的集成检测器获得清晰、精确且无电荷对比度的最完整的样品信息。
先进的功能
通过 FIB/SEM 系统采用选配的 Thermo Scientific MultiChem 或 GIS 气输送系统,实现最先进的电子和离子束诱导沉积及蚀刻功能。
无伪影成像
无伪影成像基于集成的样品清洁度管理和专用成像模式,例如 SmartScan™ 和 DCFI 模式。
短时间获得纳米级信息
借助 SmartAlign 和 FLASH 技术,任何经验水平的用户都可以最短时间获得纳米级信息。
精确的样品导航
由于 150 mm 压电载物台和选配腔室内 Nav-Cam 导航具有高稳定性和准确性,可根据具体应用需求定制精确的样品导航。
半导体设备反处理
Dx 化学处理结合等离子 FIB 束可以为高级逻辑、3D NAND 和 DRAM 提供独特、位点特定、反处理和故障分析工作流程。
高速大面积横截面成像
新一代 2.5 μA Xenon PFIB 色谱柱可实现高通量、高品质、统计学相关的 3D 表征、横截面成像和微加工。
TEM 样品制备
通过 PFIB 反处理结合 Thermo Scientific 引导工作流程,实现高质量、单层面和横截面、自上而下和倒置 TEM 样品制备。
亚纳米低能量 SEM 性能
凭借具有高电流 UC+ 单色器技术的一流 Elstar 电子色谱柱,可以在低能量下实现亚纳米性能,从而显示最细致的细节信息。
先进的自动化
执行带端点的自动反处理。SmartAlign 和 FLASH 技术使具有任何经验水平的用户在短时间内获取纳米级信息。
完整的样品信息
可通过多达六个集成在色谱柱内和透镜下的集成检测器获得清晰、精确且无电荷对比度的最完整的样品信息。
无伪影成像
通过原位自动摇摆抛光和专用成像模式(如 SmartScan 和 DCFI 模式)获取无伪影成像。
精确的样品导航
体验通过灵活的 5 轴电动平台配置和超高分辨率平台选项,专为满足不同应用需求定制的精确样品导航。
| Helios 5 PFIB CXe DualBeam | Helios 5 PFIB UXe DualBeam | |
| 电子光学系统 |
| |
| 电子束分辨率 |
| |
| 电子束参数空间 |
| |
| 离子光学系统 |
| |
| 检测器 |
| |
| 载物台和样品 | 灵活的 5 轴电动平台:
| 高精度,5 轴电动样品台(带 XYR 轴),压电驱动
|
*可选配,取决于配置
| Helios 5 PFIB CXe DualBeam | Helios 5 PFIB UXe DualBeam | Helios 5 PFIB HXe DualBeam | |
| 应用 | 先进的包装和显示研发和故障分析 | 先进的内存故障分析 | 先进的逻辑故障分析 |
| 电子光学系统 |
| ||
| 电子束分辨率 |
| ||
| 离子光学系统 |
| ||
| 载物台和样品 | 灵活的 5 轴电动平台:
| 高精度,5 轴电动样品台(带 XYR 轴),压电驱动
| 5 轴全压电陶瓷驱动 UHR 载物台
|



Thermo Fisher Scientific PFA 演示日
为满足半导体生产需求,Thermo Fisher Scientific 不断为我们行业领先的故障分析、计量和表征解决方案提供新的功能。
在 Thermo Fisher Scientific PFA 演示日中,我们展示了我们在样品制备和 FinFET 逻辑电路去层方面的全新创新。
适用于所有需求的先进 DualBeam 自动化
注册我们专有的网络讲座,以了解如何轻松使用基于 Python 的 AutoScript 4 API 将您的 DualBeam 仪器上的日常任务自动化。自动化还可以增加通量、可重现性、提高易用性、加快数据获取时间并提高效率。



Thermo Fisher Scientific PFA 演示日
为满足半导体生产需求,Thermo Fisher Scientific 不断为我们行业领先的故障分析、计量和表征解决方案提供新的功能。
在 Thermo Fisher Scientific PFA 演示日中,我们展示了我们在样品制备和 FinFET 逻辑电路去层方面的全新创新。
适用于所有需求的先进 DualBeam 自动化
注册我们专有的网络讲座,以了解如何轻松使用基于 Python 的 AutoScript 4 API 将您的 DualBeam 仪器上的日常任务自动化。自动化还可以增加通量、可重现性、提高易用性、加快数据获取时间并提高效率。
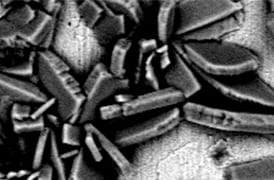
采用电镜进行过程控制
现代工业需求高通量、质量卓越、通过稳健的工艺控制维持平衡。SEM扫描电镜和TEM透射电镜工具结合专用的自动化软件,为过程监控和改进提供了快速、多尺度的信息。

显示设备故障分析
不断发展的显示技术旨在提高显示质量和光转换效率,以支持不同行业领域的应用,同时继续降低生产成本。我们的过程计量、故障分析和研发解决方案帮助显示公司解决这些挑战。