Search
先进的封装应用、复杂的互连方案和更高性能的功率器件的快速增长给故障定位和分析带来了前所未有的挑战。有缺陷或性能不佳的半导体器件通常表现出局部功率损耗的异常分布,导致局部温度升高。Thermo Scientific ELITE 系统利用锁相红外热成像 (LIT) 进行半导体器件故障定位,可以准确有效地定位这些目标区域。
LIT 是一种动态红外热成像形式,与稳态热成像相比,其可提供更好的信噪比、更高的灵敏度和更高的特征分辨率。LIT 可在 IC 半导体失效分析中用于定位线路短路、ESD 缺陷、氧化损坏、缺陷晶体管和二极管以及器件闩锁。LIT 可在自然环境中进行,无需光屏蔽箱。
锁相红外热成像系统的功能:
- 市售极高灵敏度热发射系统
- 实时锁相测量
- 几秒钟后温差分辨率 < 1 mK ;几小时后 < 10 μK
- 非接触绝对温度测绘
- 完全封装和堆叠裸片分析
- 六 位转轮,带有针对 MWIR 发射优化的定制透镜
堆叠裸片分析
堆叠裸片给分析员带来了独特的挑战 。处理粘合或 TSV 裸片堆栈时,LIT 可用于定位完全封装的器件上裸片堆栈内 X、Y 和 Z 深度的缺陷。
"无限制"数据累积时间,可获得更好的分辨率
锁相频率越高,得到的空间分辨率则越高。 然而,对于锁相红外热成像系统来说,较高的频率往往会显著降低待检测的热发射。这是许多 LIT 系统的限制。ELITE 系统通过提供一个独特的系统架构克服了这一限制,在该架构中,可以在"无限"的时间内累积更高频率的 LIT 数据。数据采集持续延长,数据分辨率提高。
采集时间越长,灵敏度越高
系统采集数据的时间越长,灵敏度越高。 当试图以极低的功率级采集数据或必须从弱故障模式中采集数据时,锁相红外热成像ELITE 系统的这一特点尤其有价值。
可选透镜灵活性
锁相红外热成像ELITE 系统可采用单透镜和相机配置,也具有 6 位转轮的灵活性。提供多种定制、高质量 MWIR 显微镜物镜,包括:28 mm 广角、1x、5x 和 10x 可获得 20x 的有效放大率,同时结合 640 InSb 相机的 15 μm 像素间距。
| 横向分辨率 |
|
| 深度分辨率 |
|
| 缺陷类型 |
|
| 样品类型 |
|
| FOV |
|
| DUT 刺激 |
|
| 获得结果时间 |
|
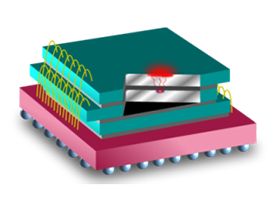
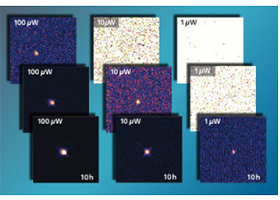
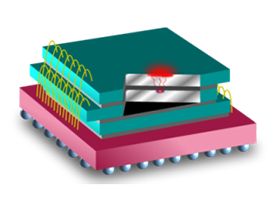
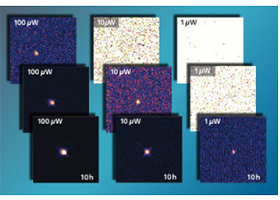

显示设备故障分析
不断发展的显示技术旨在提高显示质量和光转换效率,以支持不同行业领域的应用,同时继续降低生产成本。我们的过程计量、故障分析和研发解决方案帮助显示公司解决这些挑战。
需要了解更多锁相红外热成像系统ELITE的相关资料? 请填写下面的表格,我们会尽快与您联系!