Search
Spectra 200 扫描透射电子显微镜
为了让科学家们更好地了解复杂样品并开发新材料,他们需要稳定和精确的仪器,分析相应的构造与功能并且能够分析空间、时间和频率。
赛默飞世尔科技推出的 Thermo Scientific Spectra 200(S)TEM(具有高通量、像差矫正的扫描透射电子显微镜)可用于所有材料科学应用。
Spectra 200 扫描 透射电子显微镜 优势
所有的 Spectra 200 (S)TEM 都安装在新平台上,旨在通过被动和(可选配)主动隔振提供前所未有的机械稳定性和最高成像质量。
整个系统安装在一个完全重新设计的外壳内,内置屏幕显示,便于装载和取出样品。这是首次对无矫正器和单矫正器配置时的不同高度可以提供完全模块化和可升级性,从而为不同的房间配置提供最大的灵活性。
Spectra 200 S/TEM 可由新型冷场发射枪 (X-CFEG) 驱动。X-CFEG 具有极高的亮度 (>>1.0 x 108 A/m2/Sr/V*) 和较窄的能量分布,可在 30 – 200 kV 范围内工作。这些提供了具有高探针电流的高分辨率 STEM 成像,用于高通量、快速采集 STEM 分析。X-CFEG 和 S-CORR 聚光镜像差矫正器的强大组合支持日常 1000 pA 以上探针电流的亚埃级 STEM 成像。

此外,探针电流可在 <1 pA 至最大纳米级范围内灵活调节,同时精确控制发射枪和聚光镜系统,对探针像差的影响极小,因此可用于大多数样品和实验(见 Panther STEM 检测部分中的 MOF 示例)。
与所有冷场发射源一样,尖锐的尖端需要周期性再生(称为 flashing)以维持探针电流。使用 X-CFEG,尖端每个工作日只需 flashing 一次,这个过程不到一分钟。即使在最高分辨率成像条件下,对探针像差也没有可测量的影响,并且每日尖端 flashing 过程对尖端寿命没有影响。
X-CFEG 的尖端 flashing:在尖端再生前后无需调整光路即可在 200 kV 下保持 60 pm 的分辨率。整个过程耗时不到 1 分钟,且每个工作日仅需要一次,对尖端的寿命没有影响。
在使用大平行探针进行标准 TEM 成像实验(例如原位)时,新一代 X-CFEG 还可以产生足够的总束流 (>14 nA),从而不仅具有独特的通用性,也是高性能 C-FEG。
最新 5阶 S-CORR 聚光镜像差矫正器、增强机械稳定性以及 X-CFEG 的组合让 Spectra 200 (S)TEM 在所有加速电压下都具有高分辨率、高对比度的 STEM 成像能力。此外,Spectra 200 (S)TEM 保留了 Themis 系列产品标配的宽间隙 S-TWIN 物镜,可确保客户在不影响空间分辨率的情况下拥有“更大空间”的极靴间隙。下图中显示了 Spectra 200 S/TEM 的宽间隙 S-TWIN 在 200 kV 下的 48 pm 分辨率。
Spectra 200 S/TEM 在易用性之外增加了智能软件算法,可在 STEM 探针中快速、重复且可靠地校正高达 4 阶像差 (Auto S-CORR),并且在任何样品上都可优化 1 和 2 阶像差 (OptiSTEM+)。因此,可以每周使用 Auto S-CORR 来维护高阶像差矫正,并且可以每天使用 OptiSTEM+ 来优化图像质量,而无需标准样品或手动调整。

采用 Spectra 200 S/TEM 拍摄的锶 [110] 和氮化镓 [212],显示出宽间隙分析 S-TWIN 极靴的指定分辨率(绿色圆圈)和可实现的分辨率(红色圆圈)。在 60 kV 下,指定分辨率 96 pm,而在 200 kV 下,指定分辨率 60 pm 时可实现分辨率为 <48 pm。
Spectra 200 S/TEM 提供的 STEM 分辨率规格在 200 kV 下为 60 pm,在 60 kV 下为 96 pm,在 30 kV 下为 125 pm。有关规格的完整列表,请参阅 Spectra200 (S)TEM 产品手册。
Spectra 200 (S)TEM 重新设计为采用 Panther STEM 探头系统进行 STEM 成像,包括一个新的数据采集架构和两个新的固态八段环形和盘式 STEM 探头(共 16 段)。新的探头几何结构具有先进的 STEM 成像能力以及测量单个电子的灵敏度。

整个信号经过优化和调整,可以极低剂量提供前所未有的信噪比成像能力,便于对电子束敏感性材料进行成像。此外,完全重新开发的数据采集基础架构可以组合不同的单个探头区段,未来可能以任意方式组合检测器区段,生成新的 STEM 成像方法并揭示传统 STEM 技术中不能够获得的信息。该架构还具有可扩展性,并提供了同步多个 STEM 和谱信号的接口。

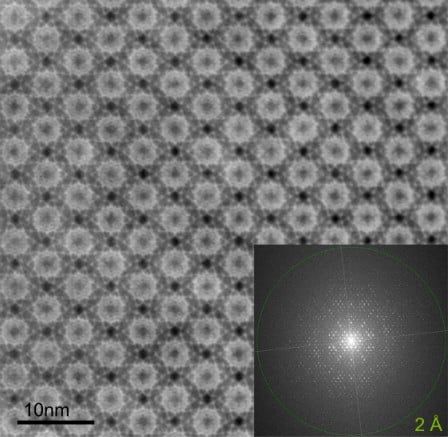
Spectra 200 (S)TEM 可配置电子显微镜像素阵列探头(EMPAD)或具有速度增强功能的 Thermo Scientific Ceta 相机,以收集 4D STEM 数据集。
EMPAD 能够在 30-300 kV 下工作并可提供高动态范围(像素间 1:1,000,000 e-)、高信噪比 (1/140 e-) 和 128 x 128 像素阵列上的高速度(每秒 1100 帧),使其成为 4D STEM 应用的最佳检测器。(例如,需要同时分析中心束和衍射束细节的应用,如下面的叠层成像图像。)
更多细节可以在 EMPAD 数据表中找到。

EMPAD 检测器可用于各种应用领域。左图中,它用于在 2D 材料 MoS2 双层中于低加速电压 (80 kV) 下将空间分辨率 (0.39 Å) 扩展到光阑限制分辨率以外 ( Jiang, Y. et al.Nature 559, 343–349, 2018)。在右边,它用于暗场反射的独立成像,揭示出高温合金中析出相的复杂微观结构(样品由曼彻斯特大学的 G. Burke 教授提供)。
当需要将 EDX 分析与 STEM 扫描中的每个点组合时,具有速度增强功能的 Ceta 相机为需要更多像素的 4D STEM 应用提供了另一种选择。该解决方案提供更高分辨率的衍射图案(高达 512 x 512 像素分辨率),适用于应力测量等应用。
Spectra 200 S/TEM 已配置为 STEM 分析的利器。X-CFEG 的极高亮度和较低色散、最新一代 5 阶 S-CORR 探针矫正器、宽间隙(S-TWIN 或 X-TWIN)极片与大立体角对称 EDS 检测器产品组合以及 Thermo Scientific Velox 软件的内置 EDX 定量引擎,让 Spectra 200 (S)TEM 上的 STEM EDX 即快速、简便又可定量。
Thermo Scientific EDX 探头系列产品提供多种探头形状选择,可满足您的实验要求并优化 EDX 结果。两种配置都具有对称设计(见下文),用于生成可量化的数据。请注意,在两种检测器配置下,样品杆对信号遮挡与倾转角的关系函数在内置的 Velox 软件功能中得到补偿。
Spectra 200 (S)TEM 可配置 Super-X(获得更干净的能谱和定量)或配置 Dual-X(获得最大立体角和高通量 STEM EDX 映射)。
Super-X 检测器系统提供 0.7 Sr 的高准直立体角和大于 4000 的 Fiori 数。 它专为光谱清洁度和量化至关重要的 STEM EDX 实验而设计。
Dual-X 检测器系统提供 1.76 Sr 的立体角和大于 2000 的 Fiori 数。 它专为高通量 STEM EDX 实验而设计,例如 EDS 断层扫描或信号产量低且快速谱图至关重要的实验。
下例中使用 Dual-X 探测器表征 DyScO3 钙钛矿系统。X-CFEG 的超高亮度 (>>1.0 x 108A/m2/Sr/V*) 和 S-CORR 探针校正器的高分辨率让探针可在 150 pA 电流和 <80 pm 尺寸下作用于样品。利用这些高亮度探针,EDX 映射可以通过高采样和高 SNR 快速完成,从而首次在亚埃空间分辨率获得单个元素、原始和未滤波的 EDX 图。Sc 图的快速傅里叶变换显示高达 90 pm 的分辨率。

使用超高亮度 X-CFEG、S-CORR 和大立体角 (1.76 Sr) Dual-X 探测器的强大组合对 DyScO3 样品进行研究时,可得到高信噪比、原子分辨率(高达 90 pm)和未经过滤的 EDX 谱图(样品由康奈尔大学的 L.F. Kourkoutis 教授提供)。
Spectra 200 S/TEM 上的电子能量损失光谱也被超高亮度加速 (>>1.0 x 108 A/m2/Sr/V*),同时 STEM 探针也可提供 X-CFEG 的固有高能量分辨率 (<0.4 eV)。
下图中,窄能量分布 (0.36 eV) 和高电流 (480 pA)、高空间分辨率 (65 pm) 探针为 STEM 成像中在高能量分辨率、噪声比和空间分辨率下采集 Dy、Sc 和 O 核损失边缘提供了理想条件。

用 Spectra 200 S/TEM 研究的 DyScO3 样品。亚-70 pm 的 STEM 探针、X-CFEG 的超高亮度及固有低能量散布 (<0.40 eV) 和 S-CORR 的分辨率可为在高信噪比下采集 Sc、O 和 Dy 核损失边缘提供理想的条件(样品由康奈尔大学的 L.F. Kourkoutis 教授提供)。
| Spectra 200 (S)TEM |
|
| 离子源 |
|
| 分析和检测器 |
|
| 可用的检测器选项 |
|

介绍 Spectra 200 (S)TEM
赛默飞世尔科技推出的 Spectra 200 S/TEM(具有高通量、像差矫正扫描透射电子显微镜)可用于所有材料科学应用。
请在下方注册以观看我们的录制网络讲座,并了解有关 Spectra 200 (S)TEM 如何为所有应用提供最高质量数据的更多信息。它采用超高亮度 X-CFEG 电子源和宽间隙极靴,具有“更多空间”,是实现原子级分辨率材料表征的最终工具。
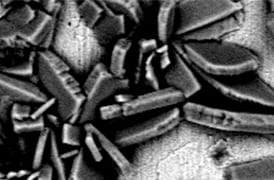
采用电镜进行过程控制
现代工业需求高通量、质量卓越、通过稳健的工艺控制维持平衡。SEM扫描电镜和TEM透射电镜工具结合专用的自动化软件,为过程监控和改进提供了快速、多尺度的信息。

显示设备故障分析
不断发展的显示技术旨在提高显示质量和光转换效率,以支持不同行业领域的应用,同时继续降低生产成本。我们的过程计量、故障分析和研发解决方案帮助显示公司解决这些挑战。
_Technique_800x375_144DPI.jpg)

_Technique_800x375_144DPI.jpg)

















_Technique_800x375_144DPI.jpg)




